Ультратонкие пленки нитрида бора для электроники следующего поколения
Международная группа исследователей представила новый материал, который может позволить совершить значительный скачок в деле миниатюризации электронных устройств
Опубликованное в престижном журнале "Nature", это исследование представляет собой значительное достижение для будущей электроники.
Синтез тонкой пленки аморфного нитрида бора
Этот прорыв стал результатом исследования, проведенного профессором Хён Сук Шин (Школа национальных наук, UNIST) и главным научным сотрудником доктором Хён Чжин Шин из Продвинутого технологического института Samsung (SAIT) в сотрудничестве с исследователями флагманского проекта Graphene из Кембриджского университета (Великобритания) и Каталонского института нанонауки и нанотехнологий (ICN2, Испания).
Подписывайтесь на наш youtube канал!
В этом исследовании группа успешно продемонстрировала синтез тонкой пленки аморфного нитрида бора (a-BN) с чрезвычайно низкой диэлектрической проницаемостью, а также высоким пробивным напряжением и превосходными барьерными свойствами металла. Группа исследователей отметила, что этот новый материал обладает большим потенциалом в качестве соединительных изоляторов в электронных схемах нового поколения.
В постоянном процессе миниатюризации логических и запоминающих устройств в электронных схемах минимизация размеров межконтактных соединений - металлических проводов, соединяющих различные компоненты устройства на чипе, - является решающим фактором, гарантирующим улучшенные характеристики и более быструю реакцию устройства. Обширные исследования были направлены на снижение сопротивления масштабируемых соединений, поскольку интеграция диэлектриков, использующих взаимодополняющие процессы, совместимые с оксидными металлами полупроводниковых (CMOS) соединений, оказалась исключительно сложной задачей. По мнению группы исследователей, необходимые материалы изоляции межсоединений должны не только обладать низкими относительными диэлектрическими константами (так называемыми k-значениями), но и быть термически, химически и механически стабильными.
В течение последних 20 лет в полупроводниковой промышленности продолжается поиск материалов с ультранизким уровнем k (относительная диэлектрическая проницаемость около или ниже 2), позволяющих избежать искусственного добавления пор в тонкую пленку. Было предпринято несколько попыток разработки материалов с требуемыми характеристиками, однако эти материалы не удалось успешно интегрировать во взаимосвязи из-за плохих механических свойств или плохой химической стабильности после интеграции, что привело к сбоям в надежности.
В данном исследовании совместными усилиями был продемонстрирован подход, совместимый с обратной линией (BEOL) для выращивания аморфного нитрида бора (a-BN) с чрезвычайно низкими диэлектрическими свойствами керамики. В частности, они синтезировали примерно 3 нм тонкого a-BN на подложке Si, используя низкотемпературное дистанционное индуктивно-связанное плазмохимическое осаждение из паровой фазы (ICP-CVD). Полученный материал показал чрезвычайно низкую диэлектрическую проницаемость в диапазоне 1,78, что на 30% ниже диэлектрической проницаемости имеющихся в настоящее время изоляторов.
I
"Мы обнаружили, что температура была самым важным параметром при идеальном осаждении пленки a-BN, происходящем при 400° C", - говорит Сокмо Хонг (Seokmo Hong), первый автор исследования. "Этот материал с ультранизким k также проявляет высокое пробивное напряжение и, вероятно, превосходные барьерные свойства металла, что делает пленку очень привлекательной для практического применения в электронной промышленности".
Для исследования химической и электронной структуры a-BN использовалась также зависящая от угла мелкая структура поглощения рентгеновских лучей ближнего действия (NEXAFS), измеренная в режиме частичного электронного поля (PEY) на линии пучка 4D источника света Pohang Light Source-II. Их результаты показали, что нерегулярное, случайное атомное расположение приводит к падению значения диэлектрической постоянной.
Новый материал проявляет также отличные механические свойства высокой прочности. Кроме того, при испытании диффузионных барьерных свойств a-BN в очень жестких условиях, исследователи обнаружили, что он способен предотвратить миграцию атома металла из соединений в изолятор. Этот результат поможет решить давнюю проблему соединений при изготовлении CMOS-интегральных схем, что позволит в дальнейшем миниатюризировать электронные устройства.
"Разработка электрически, механически и термически прочных низкокислотных материалов (k < 2) долгое время была технически сложной задачей", - говорит доктор Хён Чжин Шин из компании Samsung Advanced Institute of Technology (SAIT). "Наши исследования также являются прекрасным примером того, как компании и академические институты совместно работают над созданием большего синергетического эффекта".
"Наши результаты показывают, что аморфный аналог двухмерной шестиугольной BN обладает идеальными диэлектрическими характеристиками с низким уровнем КК для высокопроизводительной электроники", - говорит профессор Шин. "Если они будут коммерциализированы, это будет большим подспорьем в преодолении надвигающегося кризиса в полупроводниковой промышленности". опубликовано econet.ru по материалам eurekalert.org
Подписывайтесь на наш канал Яндекс Дзен!
P.S. И помните, всего лишь изменяя свое потребление - мы вместе изменяем мир! © econet
Источник: https://econet.kz/
Понравилась статья? Напишите свое мнение в комментариях.Подпишитесь на наш ФБ: , чтобы видеть ЛУЧШИЕ материалы у себя в ленте!



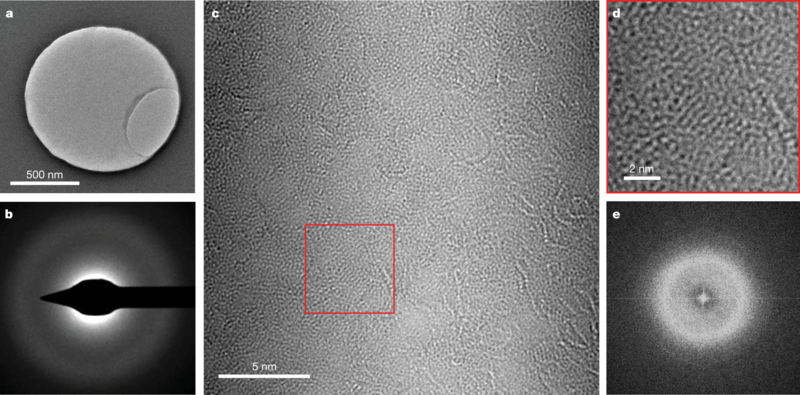

Добавить комментарий